先进半导体封装 2025-2035:预测、技术、应用
半导体封装技术的演变
半导体封装已经从1D PCB发展到晶圆级先进3D混合键合,实现了个位数微米互连间距和高能效1000 GB/s带宽。先进半导体封装技术的核心是 2.5D 封装(其中组件并排放置在转接板上)和 3D 封装(涉及垂直堆叠有源晶片)。这些技术对于 HPC 系统的未来至关重要。
2.5D 封装技术涉及各种中介层材料,每种材料都有明显的优点和缺点。硅(Si)中介层,包括全无源硅晶片和局部硅桥,以促进最精细的布线功能而闻名,使其成为高性能计算的理想选择。然而,它们在材料和制造方面都具有很高的成本,并且在包装领域面临限制。为了缓解这些问题,越来越多地使用局部硅桥,战略性地利用需要精细特性的硅,并解决面积限制问题。
使用扇出模塑料的有机中介层是比硅更具成本效益的替代品。它们具有较低的介电常数,从而减少了封装中的RC延迟。尽管有这些优势,但有机中介层难以实现与硅基封装相同水平的互连功能减少,从而限制了它们在高性能计算应用中的采用。
玻璃中介层引起了人们的极大兴趣,尤其是在英特尔最近推出了基于玻璃的测试车辆封装之后。玻璃具有可调的热膨胀系数(CTE)、高尺寸稳定性、光滑平坦的表面以及支持面板制造的能力等优点,使其成为具有可与硅相媲美的布线功能的中介层的有前途的候选者。然而,玻璃中介层的主要缺点是生态系统不成熟,目前缺乏大规模生产能力,此外还存在技术挑战。随着生态系统的成熟和生产能力的提高,半导体封装中的玻璃基技术可能会进一步增长和采用。
在3D封装技术方面,Cu-Cu无凸块混合键合正在成为一项领先的创新。这种先进的技术通过将介电材料(如SiO2)与嵌入式金属(Cu)相结合,实现了永久互连。Cu-Cu混合键合可以实现低于10微米的间距,通常在个位数微米范围内,这比传统的微凸块技术有了显着改进,传统的微凸块技术具有大约40-50微米的凸块间距。混合键合的好处包括增加I/O、提高带宽、改进3D垂直堆叠、提高能效,以及由于没有底部填充而减少寄生效应和热阻。然而,这种技术的制造很复杂,成本更高。
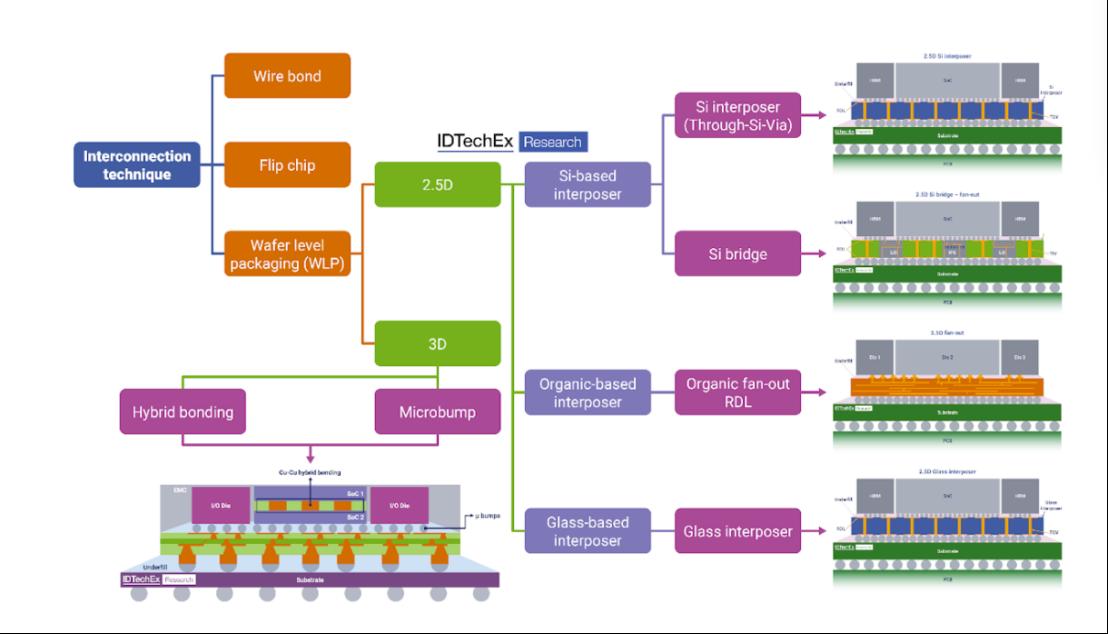 半导体封装互连技术概述。来源:Advanced Semiconductor Packaging 2025-2035
半导体封装互连技术概述。来源:Advanced Semiconductor Packaging 2025-2035
2.5D和3D封装技术包括各种封装技术。在2.5D封装中,中介层材料的选择将其分为硅基、有机基和玻璃基中介层,如上图所示。同时,在3D封装中,微凸块技术的发展旨在实现更小的间距尺寸。然而,今天通过采用混合键合技术(一种直接连接Cu-Cu的方法)实现了个位数的间距尺寸,这表明该领域的重大进步。
值得关注的2.5D和3D包装发展的主要趋势:
更大的中介层区域
IDTechEx此前曾预测,由于硅中介层的局限性,2.5D硅桥解决方案将很快取代硅中介层成为封装HPC芯片的主要选择,它难以超过3倍的掩模层尺寸。TSMC是NVIDIA和其他主要HPC开发商(如Google和Amazon)的2.5D硅中介层的主要供应商,最近宣布以3.5倍标线尺寸大批量生产其第一代CoWoS_L。IDTechEx预计这一趋势将继续下去,他们的报告中涵盖了主要参与者,探讨了进一步的进展。
面板级封装
正如Semicon Taiwan 2024所强调的那样,面板级封装已成为一个重要的焦点。这种封装方法允许使用更大的中介层,并通过同时生产更多封装来帮助降低成本。尽管具有潜力,但仍需要解决翘曲管理等挑战。它的日益突出反映了对更大、更具成本效益的中介层的需求不断增长。
玻璃中介层
玻璃正在成为实现精细布线的有力候选者,可与硅相媲美,并具有可调热膨胀系数(CTE)和更高的可靠性等额外优势。玻璃中介层还与面板级封装兼容,以更可控的成本提供高密度布线的潜力,使其成为未来封装技术有前途的解决方案。
HBM的混合键合
3D铜-铜(Cu-Cu)混合键合是在芯片之间实现超细间距垂直互连的关键技术。该技术已应用于多种高端服务器产品中,包括用于堆叠SRAM和CPU的AMD EPYC,以及用于在I/Otile上堆叠CPU/GPU tile的MI300系列。预计混合键合将在未来的HBM发展中发挥关键作用,特别是对于超过16-Hi或20-Hi层的DRAM堆栈。
共封装光学器件(CPO)
在对更高数据吞吐量和更高能效的需求不断增长的推动下,光互连技术获得了相当大的牵引力。共封装光学器件(CPO)正在成为提高I/O带宽和降低能耗的关键解决方案。与传统的电传输相比,光通信具有多种优势,包括信号随距离的衰减更低、对串扰的敏感性更低以及带宽显著提高。这些优势使CPO成为数据密集型、高能效HPC系统的理想选择。
值得关注的主要市场
推动2.5D和3D封装技术发展的主要市场无疑是高性能计算(HPC)领域。这些先进的封装方法对于克服摩尔定律的局限性至关重要,可以在单个封装中实现更多的晶体管、存储器和互连。芯片的分解还允许在不同的功能块之间实现最佳工艺节点利用率,例如将I/O tiles 与处理 tile 分离,从而进一步提高效率。
除了 HPC,其他市场也有望通过采用先进的封装技术实现增长。在 5G 和 6G 领域,天线级封装和尖端芯片解决方案等创新将塑造无线接入网络 (RAN) 架构的未来。自动驾驶汽车也将受益,因为这些技术支持传感器套件和计算单元的集成,以处理大量数据,同时确保安全性、可靠性、紧凑性、功率和热管理以及成本效益。
消费电子产品(包括智能手机、智能手表、AR/VR 设备、PC 和工作站)虽然更注重成本,但越来越注重在更小的空间内处理更多数据。先进半导体封装将在这一趋势中发挥关键作用,尽管封装方法将与 HPC 中使用的封装方法不同。IDTechEx 对这些行业进行深入分析,研究先进封装技术将如何影响它们并提供市场预测。
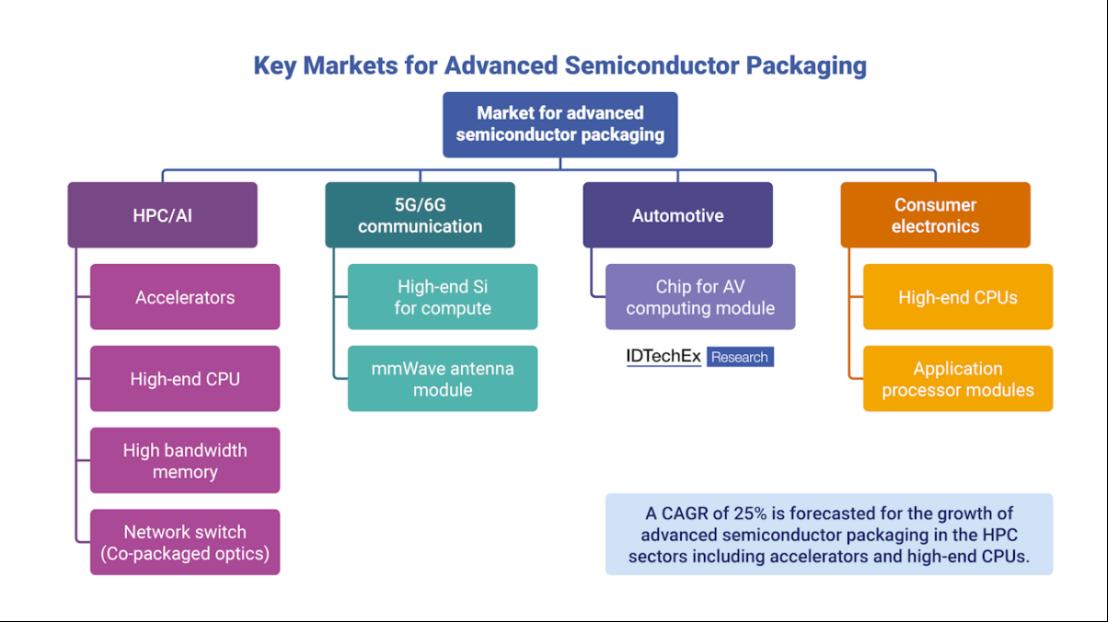
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。







